| 2017 U. Malaya, Malysia |
Formation of neodymium oxide by thermal oxidation of
sputtered Nd thin film on Si substrate |
N-type Si(100) substrate, [Native oxide was
removed by hydrofluoric acid (HF) (1 HF :50 H2O) dipping for 10 s. ] |
Nd
| Target |
Nd |
| Thickness |
10 nm |
| Depo. |
rfSputt. |
| Temp. |
R.T. |
| Gas |
Ar 20 cm3/min |
| Pressure |
3.0 × 10−3 Pa, |
| Power |
170W |
| Distance |
20 cm |
|
| Equip. |
Tube Furnace |
| Temp |
500C-1100C |
| Time |
|
| Heating rate |
10 C/min |
| Ambient |
O2 150
cm3/min |
| Pressure |
AP |
|
|
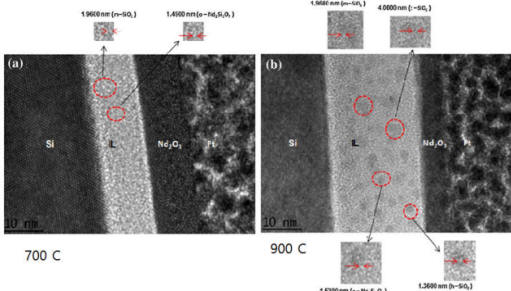 |
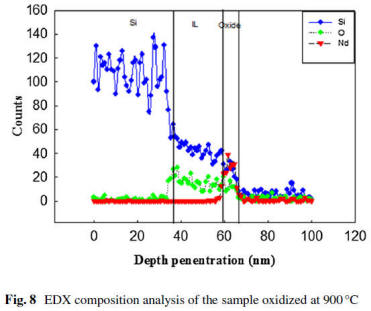 |
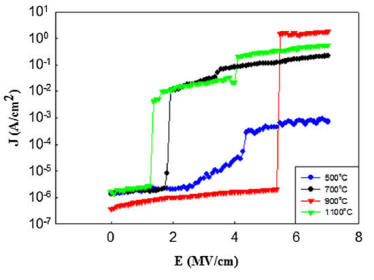 |
| 2006 Taiwan |
Structural and electrical properties of neodymium oxide high- k gate
dielectrics |
p-type 100 oriented silicon wafers with resistivity
of 7–11 Ohm cm |
Nd
| Target |
Nd 3" |
| Thickness |
10 nm |
| Depo. |
rfSputt. |
| Temp. |
R.T. |
| Gas |
Ar12.5 sccm, O2 12.5sccm |
| Pressure |
~10mTorr |
| Power |
170W |
| Distance |
20 cm |
|
| Equip. |
RTA |
| Temp |
600C -800C |
| Time |
30s |
| Heating rate |
|
| Ambient |
N2 150
cm3/min |
| Pressure |
AP |
|
the back- side contact of Si wafer deposited a 4000 Å
thickness of Al film |
 |
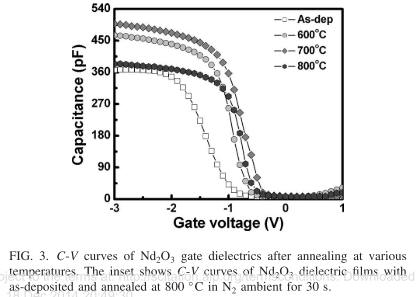 |
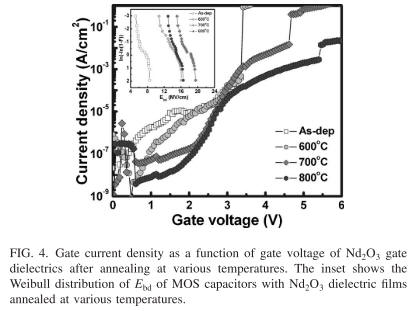 |